| +11 голос |
|
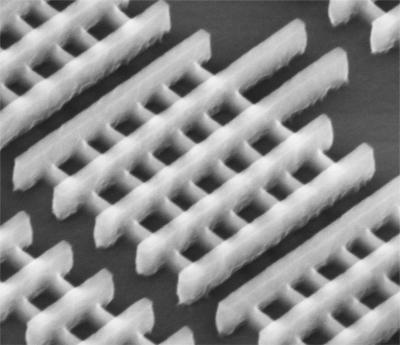
Технология Through-Focus Scanning Optical Microscopy (TSOM), созданная несколько лет назад в Национальном институте стандартов и технологий (National Institute of Standards and Technology, NIST) для улучшения оптических микроскопов, теперь нашла применение в качестве средства контроля компонентов цепей компьютерных чипов следующих поколений.
На протяжении многих десятилетий микросхемы оставались практически двумерными. Однако, тенденция к уплотнению заставила конструкторов микрочипов пойти по пути вертикального роста, уже проторенному планировщиками застройки мегаполисов. В новых поколениях интегральных схем компоненты накладываются друг на друга, и для того, чтобы контролировать правильность такого размещения, потребовалось создать совершенно новые техники измерения.
Если прежде требовалось лишь точно определить ширину дорожки, составляющую несколько нанометров, то теперь нужно замерить все слайды трехмерной структуры, более сложной, чем многие современные здания. И волновая природа света не делает эту процедуру проще, ограничивая разрешение пределом примерно в 250 нм.
Методом TSOM оказалось удобно отслеживать мельчайшие (до 10 нм, а возможно и меньше) различия в форме трехмерных компонентов микросхем. Он использует обычные световые микроскопы, но получает множество плоских изображений на разном расстоянии от объекта, формируя трехмерное пространство данных.
Компьютер, затем, извлекает профили яркости из многочисленных расфокусированных снимков и использует различия между ними для построения изображения TSOM. Эти картинки выглядят несколько абстрактно, но успешно справляются с задачей, визуализируя мельчайшие расхождения в измеряемых структурах.
Детали метода TSOM описываются в статье «Critical dimension metrology by through-focus scanning optical microscopy beyond the 22 nm node», вышедшей в журнале Applied Physics Letters.
Стратегія охолодження ЦОД для епохи AI
| +11 голос |
|


